
IBM acaba de presentar su tecnología DBHi, un puente de silicio para interconectar dos chips en vertical sin la necesidad de vías a través de silicio o TSV. El cual competirá con otras soluciones similares en el mercado. ¿Su mayor ventaja? Promete ser más barata de fabricar e implementar que las ya existentes.
Uno de los desafíos de los circuitos integrados en tres dimensiones o 3DIC está en el tipo de interconexiones utilizadas para conectar verticalmente los diferentes chips de lógica y/o memoria entre sí. El método más conocido es el TSV, pero las complicaciones y sobrecoste en su fabricación ha hecho que diferentes fundiciones acaben desarrollando soluciones alternativas, basadas todas ellas en los llamados puentes de silicio para la interconexión. Hasta ahora conocíamos la tecnología EMIB de Intel y la X3D de AMD, esta última en colaboración con TSMC.
La última en sumarse ha sido IBM, que ha desarrollado un puente de silicio que promete abaratar los costes de producción de futuros diseños 3DIC, a la que han bautizado como DBHi.
Intel simplifica los puentes de silicio con tecnología DBHi
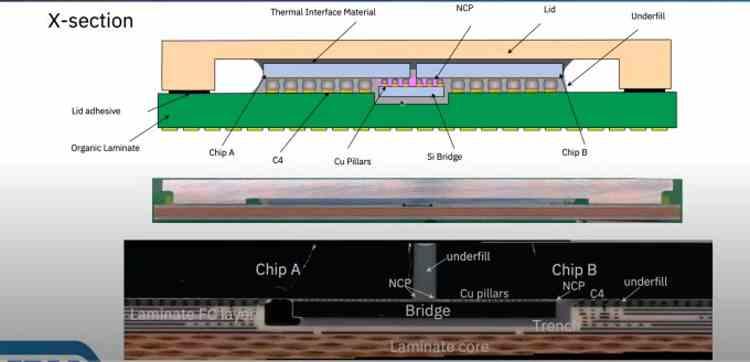
Hace tiempo que IBM dejó de fabricar chips, no por ello ha dejado de investigar en el desarrollo de nuevas tecnologías, como el desarrollo de un nodo de 2 nm y ahora nos sorprenden con el desarrollo de su puente de silicio, al cual han bautizado como DBHi, siglas que significan direct bonded heterogenous integration. El cual consiste en un puente de silicio para interconectar dos chips en vertical, sin la necesidad interconexiones TSV, el cual se sitúa entre las capas de los procesadores fabricados en vertical, para futuras CPUs, GPUs y APUs en modelos 3DIC y 2.5DIC.
La principal diferencia entre esto y la tecnología Intel EMIB es que los chips se unen al laminado con protuberancias C4 estándar y el puente conecta los chips o chiplets con micro protuberancias formadas en cada lado del puente de silicio. Un diseño que resulta más simple que el de Intel y por tanto más fácil de fabricar que este. No sabemos por el momento si alguna fundición va a adoptar esta tecnología para futuras configuraciones 2.5DIC y 3DIC, ya que Intel y TSMC, las dos mayores tienen sus propias soluciones desarrolladas.
La aparición de los chips con configuraciones 3DIC y 2.5DIC se han visto como la solución para muchos de los problemas de la Ley de Moore a la hora de escalar el rendimiento de los chips a futuro. Su no adopción se ha dado por el alto coste a la hora fabricar este tipo de circuitos integrados utilizando las vías a través de silicio. Lo cual ha forzado que la investigación y desarrollo en este campo por parte de las grandes fundiciones.
El futuro pasa por los puentes de silicio
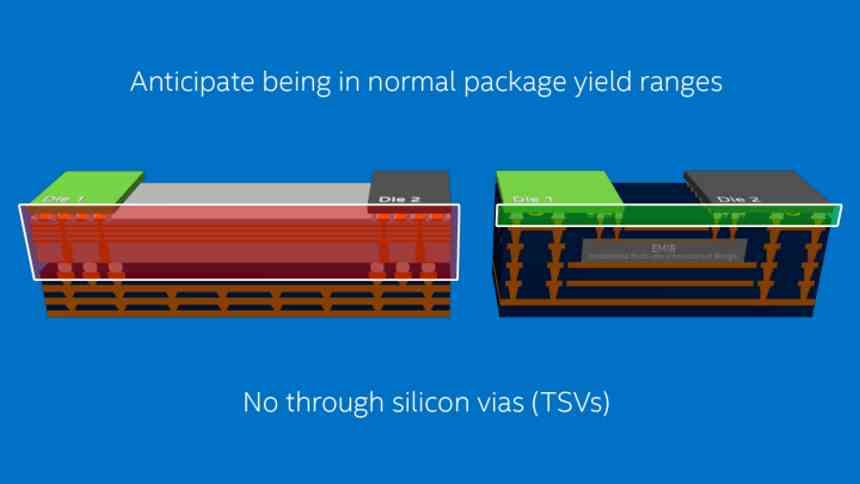
El ancho de banda necesario para interconectar los futuros chips requieren interconexiones en vertical, ya que esto permite aumentar la cantidad de interconexiones. La ventaja de esto es que permite reducir el consumo energético para la intercomunicación a niveles tolerables. Algo que sería totalmente de conseguir con la clásica conectividad en serie.
Tenemos casos como Intel Foveros y EMIB, así como la futura tecnología X3D de AMD. Las cuales se utilizarán para futuros procesadores para servidores y centros de datos. No obstante no podemos olvidar también el desarrollo de nuevos procesadores para servidor basados en arquitecturas como ARM y RISC-V, donde el desarrollo de IBM de licenciarse les va a dar un gran empujón de cara a diseños mucho más avanzados.
Fuente: HardZone